IGBT功率模块封装技术有哪些
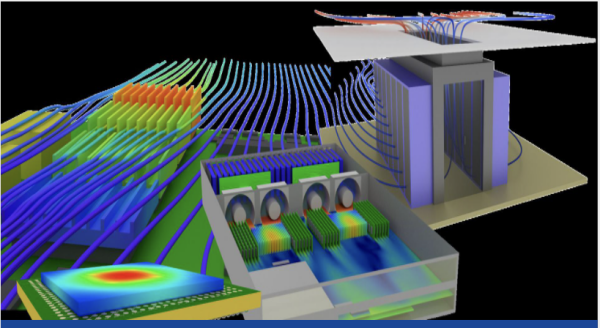
IGBT模块是新一代的功率半导体电子元件模块,诞生于20世纪80年代,并在90年代进行新一轮的改革升级,通过新技术的发展,现在的IGBT模块已经成为集通态压降低、开关速度快、高电压低损耗、大电流热稳定性好等等众多特点于一身,而这些技术特点正式IGBT模块取代旧式双极管成为电路制造中的重要电子器件的主要原因。
近些年,电动汽车的蓬勃发展带动了功率模块封装技术的更新迭代。目前电动汽车主逆变器功率半导体技术,代表着中等功率模块技术的先进水平,高可靠性、高功率密度并且要求成本竞争力是其首先需要满足的要求。
01
功率器件模块封装结构演进趋势
IGBT作为重要的电力电子的核心器件,其可靠性是决定整个装置安 全运行的重要因素。由于IGBT采取了叠层封装技术,该技术不但提高了封装密度,同时也缩短了芯片之间导线的互连长度,从而提高了器件的运行速率。传统Si基功率模块封装存在寄生参数过高,散热效率差的问题,这主要是由于传统封装采用了引线键合和单边散热技术,针对这两大问题,SiC功率模块封装在结构上采用了无引线互连(wireless interconnection)和双面散热(double-side cooling)技术,同时选用了导热系数更好的铝碳化硅或其他材料,并尝试在模块结构中集成去耦电容、温度/电流传感器以及驱动电路等,研发出了多种不同的模块封装技术。
01
直接导线键合结构(DLB)
直接导线键合结构的特点就是利用焊料,将铜导线与芯片表面直接连接在一起,相对引线键合技术,该技术使用的铜导线可有效降低寄生电感,同时由于铜导线与芯片表面互连面积大,还可以提高互连可靠性。三菱公司利用该结构开发的IGBT模块,相比引线键合模块内部电感降低至57%,内部引线电阻减小一半。
02
SKiN结构
SKiN模块结构也是一种无引线键合的结构,它采用了双层柔软的印刷线路板同时用于连接MOSFET和用作电流通路。
03
2.5D和3D模块封装结构
为进一步降低寄生效应,使用多层衬底的2.5D和3D模块封装结构被开发出来用于功率芯片之间或者功率芯片与驱动电路之间的互连。在2.5D结构中,不同的功率芯片被焊接在同一块衬底上,而芯片间的互连通过增加的一层转接板中的金属连线实现,转接板与功率芯片靠得很近,需要使用耐高温的材料,低温共烧陶瓷(LTCC)转接板常被用于该结构。
以上是IGBT功率模块封装技术有哪些的介绍,提供大家参考。

随着物联网、大数据和人工智能驱动的新计算时代的发展,对半导体器件的需求日益增长,同时也催生了市场对半导体材料的需求,半导体材料行业迎来快速发展的黄金期。在国家鼓励半导体材料国产化的政策导向下,本土半导体材料厂商不断提升半导体产品技术水平和研发能力,逐渐打破了国外半导体厂商的垄断格局,推进中国半导体材料国产化进程,促进中国半导体材料行业的发展。
数据显示,2017-2019年中国半导体材料市场规模逐年增长,从2017年的76亿美元增长至2020年的94亿美元。据统计,2017-2020年全球62座新投产的晶圆厂中有26座来自中国大陆,占比超过40%,成为增速最快的地区。伴随着5G时代的来临,汽车电动化进程拉动IGBT规模增长。得益于对清洁能源高速增长的需求,IGBT市场规模将持续增长,IGBT市场在2020年的规模为54亿美元,从2020年到2026年将以7.5%的复合年增长率(CAGR)增长,预计2026年市场规模为84亿美元。新能源车应用作为IGBT市场规模的重要增量,2020年市场规模为为5.09亿美元,2020-2026年的复合年增长率为23%,预计2026年新能源车用IGBT市场规模为17亿美元。
随着5G、智慧物联网时代的到来,中国大陆的半导体产业得以在众多领域实现快速与全面布局,正逐步驱使全球半导体产业从韩国、中国台湾向中国大陆转移。目前,我国已经成为最大的半导体市场,并且继续保持最快的增速,预计半导体市场增长将持续带动半导体材料行业快速发展。